文 | 半导体产业纵横,作家 | 丰宁
"光刻将不再那么垂危。"这句话一出便在业界引起巨大争议,这句话来源于英特尔的一位高管。
光刻机,向来被视为半导体制造的命根子。但近期多家芯片巨头开释的信息高傲,将来光刻时刻可能不再是惟一礼聘,即等于很难抢到的 High-NA EUV,也多处于"闲置"气象。
High-NA EUV 光刻机,面对滞销
客岁,High-NA EUV 热度很高。
ASML 官网高傲,其拼装了两个 TWINSCAN EXE:5000 高数值孔径光刻系统。其中一个由 ASM 与 imec 配合开采,将于 2024 年装配在 ASML 与 imec 的鸠集实验室中,展望 2025 年参加量产。另一个由英特尔在 2018 年订购,2023 年 12 月,ASML 厚爱向英特尔录用了首个 High-NA EUV 光刻系统—— TWINSCAN EXE:5000 的首批模块。
2024 年头,这台光刻机主要组件运抵英特尔;11 月,台积电称年底前会收到 ASML 起原进的 High-NA EUV 光刻机。2025 年 3 月,三星在韩国华城园区引入首台 ASML 造的 TWINSCAN EXE:5000 ,成为英特尔、台积电之后第三家购入的半导体厂商,且三星决定在将来 DRAM 出产顶用该时刻,竞争敌手 SK 海力士也有此盘算。
可在实验应用里,芯片巨头们却对 High-NA EUV 打了退堂饱读。
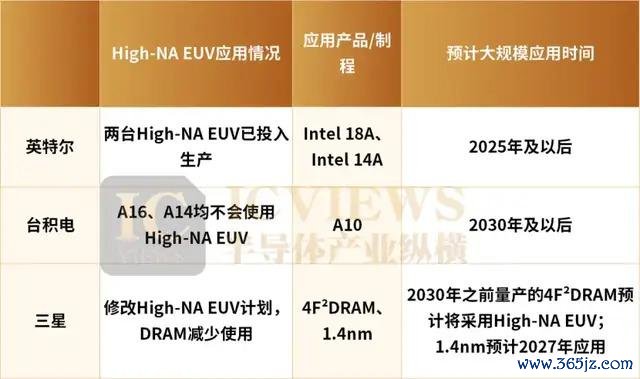
在此前霸术里,英特尔大约是应用 High-NA EUV 光刻机最早的公司。
近日,英特尔示意,ASML 的首批两台顶端光刻机已在其工场"参加出产",数据高傲它们比早期型号更可靠。英特尔高等首席工程师 Steve Carson 示意,英特尔诈欺 ASML 的 High-NA EUV 光刻机,在一个季度内出产 30000 片晶圆,这种大型硅片不错出产数千个规画芯片。
英特尔盘算使用 High-NA EUV 建树来匡助开采 Intel 18A(1.8nm)制造时刻,该时刻盘算于本年晚些时候与新一代 PC 芯片全部量产。该公司示意,盘算诈欺 High-NA EUV 建树全面参加下一代制造时刻 Intel 14A(1.4nm)的出产,但尚未涌现该时刻的量产日历。
台积电:High-NA EUV 大规模应用,最少还需 5 年
对于 High-NA EUV,台积电一直是比较默默的存在。
此前台积电业务开采资深副总司理张晓强示意,天然对 High-NA EUV 智力印象久了,但建树价钱逾越 3.5 亿欧元(3.78 亿好意思元)。当今的递次型 EUV 光刻机,仍不错提拔台积电顶端制程的出产到 2026 年,台积电顶端制程 A16 也将会连续领受递次型 EUV 光刻机来进行出产。
在最近于荷兰阿姆斯特丹举行的台积电时刻论坛欧洲站行动上,张晓强再度重申了其对 High-NA EUV 光刻机的长期态度,该公司的 A16(1.6nm 级)和 A14(1.4nm 级)工艺时刻齐不会领受 High-NA EUV 光刻机。
据悉,台积电的时刻团队仍是找到了一种在 A14 节点上出产芯片的方式,而无需使用 High-NA EUV 光刻机,与递次型的低数值孔径 EUV 系统的 13.5nm 分散率比较,该器用可提供 8nm 分散率。
此前台积电曾示意磋商用 High-NA EUV 微影曝光机出产 A10 制程芯片,比其盘算于 2025 年底 2nm 当先约两代,这也代表了2030 年后才能看到这种机器大规模量产。
三星推迟 High-NA EUV 使用盘算,代工从 1.4nm 开动
尽管三星已引进了 High-NA EUV 光刻机,但这家公司也并莫得惊惶参加使用。
据悉,三星过甚竞争敌手 SK 海力士均已决定推迟在 DRAM 出产中引入 High-NA EUV 时刻的时代。原因是器用建树的资本过高,另外 DRAM 架构行将发生变化,从而让存储器制造商在 High-NA EUV 时刻上选用更为严慎的格调。
字据三星和 SK 海力士的盘算,DRAM 架构将分阶段发展——从 6F² 到 4F²,最终发展到 3DDRAM。2030 年之前量产的 4F²DRAM 将需要 EUV 时刻惩办,展望将领受 High-NA EUV 器用。不外与传统 DRAM 不同,3D DRAM 通过垂直堆叠增多晶体管密度,并不一定需要用到 EUV 时刻,不管是夙昔的 EUV 照旧 High-NA EUV 器用,从而摒除了对 EUV 时刻的需求。这意味着即便投资了 High-NA EUV 光刻机,但实验部署到 DRAM 出产的窗口期可能相对较短。
三星也会将 High-NA EUV 时刻引入到逻辑芯片的出产中,正在评估 1.4nm 工艺中的使用,概念 2027 年量产。
刻蚀时刻,成为新焦点
在半导体制造中,刻蚀是仅次于光刻的中枢工艺,径直决定芯片性能、良率和集成度。跟着先进制程向 3nm 及以下演进,刻蚀设施从传统制程的 10% 占比激增至 50% 以上(以 5nm FinFET 为例,刻蚀次数超 150 次)。
据投资连络平台 Tegus 表现的照顾内容,一位匿名英特尔总监示意,将来晶体管假想将裁减对先进光刻建树的依赖,转而提高刻蚀时刻的中枢性位。
他以为,跟着全环绕栅极场效应晶体管和互补场效应晶体管(CFET)等新式结构的发展,高端芯片制造对光刻要道的总体需求将会安适。
在光刻要道,ASML EUV 及 High-NA 光刻机将电路假想转印至晶圆。后惩办要道,通过千里积工艺添加材料,再经刻蚀工艺礼聘性去除材料酿成晶体管结构。
这位高管强调,GAAFET 与 CFET 等三维晶体管结构条款"从各个标的包裹栅极",使得横向去除过剩材料成为盘曲,"制造商将更专注于通过刻蚀工艺去除材料,而非延长晶圆在光刻机中的惩办时代来缩小特征尺寸。"
苟简来讲,跟着芯片制造中横向标的的垂危性日益增多,High-NA EUV 的垂危性比较于 EUV 就没那么垂危了。
与此同期,Lam 等芯少顷蚀公司将发达更多的作用。
那么光刻机便不再垂危了吗?非也。
将来芯片制造将减少对 ASML High-NA EUV 光刻机的依赖,但业界对该建树的需求依旧高出大。
这位高管示意:"在 7nm 时刻节点近邻,EUV 光刻曾起到盘曲作用,往后这类需求会减少。之是以这样,不仅仅因为咱们在探寻高深的侧向材料去除与操控方式,还触及晶圆对晶圆(wafer- to -wafer )的时刻。存储芯片与逻辑芯片厂商,不再把悉数东西齐挤压在单晶圆上、让制造难度陡增,而是开动在晶圆后头或晶圆之间寻找‘空间’。
这样作念的收尾,是裁减对最小特征尺寸的依赖—— 毕竟,能在垂直维度和给定平面上,齐竣事高密度集成。打个譬如,不再局限于平铺 ‘郊区’,而是搭建 ‘摩天大楼’。建 ‘摩天大楼’ 时,光刻的需求仍在,但不像打造 ‘郊区’(依赖小特征尺寸)时那么盘曲。咱们不是只在一个标的用力压缩,而是尝试双向拓展空间。"
ASML EUV,还能走多远?
上述不雅点一出,业内对于 ASML 的护理度再上一个层级。
业界聚焦的问题主要有三:一是 ASML 年度光刻机出货量;二是其下一代居品进展;三是 ASML 的 EUV 时刻还能走多远?
对于第一个问题,ASML 2024 年财报高傲,其光刻机全年销量 418 台,包括 44 台 EUV 光刻机、374 台 DUV 光刻机,另外还卖出了 165 台计量和检测系统。
收入来源方面,中国大陆 2024 年为 ASML 孝敬了 101.95 亿欧元收入 ( 约合东谈主民币 797.71 亿元 ) ,占比高达 36.1%,遥遥当先。
其次是韩国 64.09 亿欧元,占比 22.7%;好意思国 45.22 亿欧元,占比 16.0%;中国台湾 43.54 亿欧元,占比 15.4%;欧洲 13 亿欧元,占比 4.6%;日本 11.56 亿欧元,占比 4.1%。
ASML 指出,市集需求不及、晶圆厂准备不及,导致客户对 EUV 光刻机的需求也在推迟,然而DVU 光刻机需求仍然逾越录用智力,尤其是来自中国市集的需求十分强盛。
对于第二个问题,在 High-NA EUV 顺利推出的同期,ASML 和蔡司还在连络新一代数值孔径为 0.75 NA 的 Hyper NA EUV 光刻系统。
Jos Benschop 示意,Hyper NA EUV 光刻系统的物镜并不一定非得更大,"你也不错把终末一面镜子放在离芯片更近的场所,这样你就会赢得雷同的收尾。弱点是更多的后光会反射缅想——这就是镜子的情况。"
Hyper NA EUV 还有一个优点,更大的数值孔径不错惩办更多的后光,就像你倒空宽颈的瓶子比清空窄颈的瓶子更快。因此,Hyper NA EUV 不仅能够打印出更明晰的线条,而且打印速率也更快。
字据 Martin van den Brink 此前表现的 ASML 将来 15 年的逻辑器件工艺路子图,诈欺当今的 0.3NA 的递次型 EUV 光刻机提拔到 2025 年 2nm 的量产,再往下就需要通过多重曝光时刻来竣事,但提拔到 2027 年量产的 1.4nm 将会是极限。

对于第三个问题,字据 Research and Markets、Future Market Insights 数据,ASML 端正着环球 75% 至 80% 的 EUV 光刻市集,当时刻无东谈主能及。ASML 为悉数主要芯片制造商提供居品,实验上把持了 EUV 系统辖域,该领域孝敬了其近四分之一的总收入。
ASML 的 EUV 时刻重塑了芯片制造业,况兼很可能在将来至少 10 到 20 年内保执盘曲地位。
天然,在这个流程中,ASML 也需要面对来自业界各方的挑战。
新式光刻时刻,不竭面世
此外,当今 ASML 的 EUV 光刻机所领受的是被称为激光等离子体 EUV 光源(EUV-LPP),但跟着半导体制程的执续激动,EUV-LPP 也将面对更多的挑战。手脚 LPP-EUV 时刻的替代,频年来,好意思国、中国、日本等国度的连络机构齐在研发基于直线电子加快器的摆脱电子激光时刻的 EUV 光源(EUV-FEL)系统,该时刻诈欺磁铁影响电子,不错产生任何波长的光,况兼其光源功率足以同期提拔 10~20 台 EUV 光刻机。这种方式不仅不错绕过 ASML 所领受的 EUV-LPP 时刻路子,还可大幅裁减 EUV 光源的系统资本。
ASML 在 2015 年控制也连络了 EUV-FEL 时刻,天然该时刻是有用的,却不相宜现时需求。因为粒子加快器体积盛大澌灭了悉数这个词建筑物,并不适应现时的晶圆厂。而且,一朝 EUV-FEL 光源产生故障或需要抠门,那么接入该光源的 10 多条出产线齐将面对停机问题。对于大巨额的芯片制造商或者晶圆代工场商来说,要是其在一个地区只建几座晶圆厂,那么也就莫得必要用这样的一个重型光源。
好意思国初创公司 Xlight 评释称,它但愿在 2028 年将 EUV-FEL 光源的原型与 ASML 机器贯穿起来。
初创公司 Lace LithographyAS ( 挪威卑尔根 ) 也正在开采一种光刻时刻,该时刻使用向名义放射的原子来界说特征,其分散率超出了极紫外光刻时刻的极限。
Lace Litho 所称的 BEUV 表面上不错竣事更紧密的特征,提拔晶体管的执续微型化并延迟摩尔定律。
传统的 EUV 系统使用 13.5nm 波长的光,通过一系列反射镜和掩模在晶圆上酿成图案。原子光刻时刻能够竣事径直无掩模图案化,其分散率甚而小于受波长截止的 EUV 系统所能达到的分散率。
该公司在其网站上宣称:"通过使用原子代替光,咱们为芯片制造商提供了当先现通常刻 15 年的功能,而且资本更低、能耗更低。"
除了上述时刻外,纳米压印光刻、电子束光刻机等新式光刻时刻也在不断发展。纳米压印光刻通过压印模具的面貌,径直将图案复制到光刻胶上,比较传统光刻,能够以更低的资本竣事高分散率图形转动,仍是在一些特地领域赢得应用。电子束光刻机则不错径直诈欺电子束在光刻胶上绘画图案,具有极高的分散率和天真性,特地适用于小批量、高精度芯片的制造。
尽管当今 ASML 凭借教训的产业链、盛大的装机量以及沉稳的客户相关占据上风体育游戏app平台,但新兴时刻带来的潜在胁迫阻碍冷落。



